如今半導體的制程工藝已經進步到了7nm,再往后提升會越來越難。想要提升芯片性能還可以從晶圓封裝上下文章。
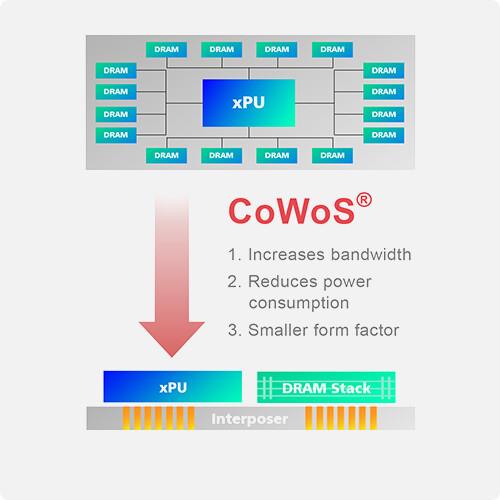
此前臺積電曾推出過CoWoS(Chip on Wafer on Substrate)封裝技術,將邏輯芯片和DRAM 放在硅中介層(interposer)上,然后封裝在基板上。這是一種2.5D/3D封裝工藝,可以讓芯片尺寸更小,同時擁有更高的I/O帶寬。不過由于成本較普通封裝高了數倍,目前采用的客戶并不多。
3月3日,臺積電宣布將與博通公司聯手推出增強型的CoWoS解決方案,支持業界首創的兩倍光罩尺寸(2Xreticlesize)之中介層,面積約1,700平方毫米。
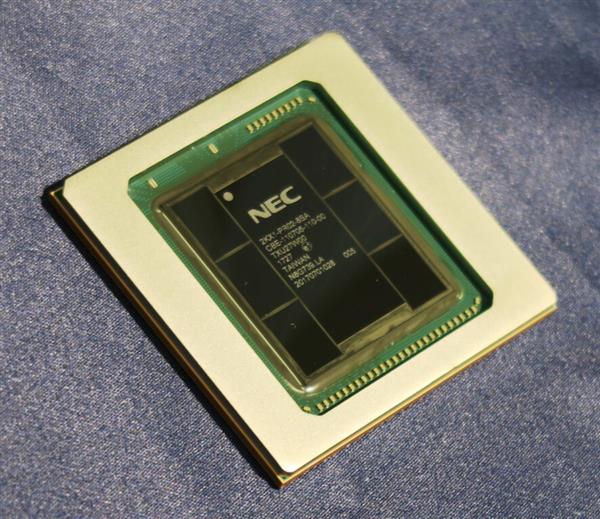
新的增強型CoWoS平臺能夠容納將多個邏輯系統單晶片(SoC),最高提供96GB的HBM內存(6片),帶寬高達2.7TB/s。相較于前代CoWoS提升了2.7倍。如果是和PC內存相比,提升幅度在50~100倍之間。
臺積電表示此項新世代CoWoS平臺能夠大幅提升運算能力,藉由更多的系統單芯片來支援先進的高效能運算系統,并且已準備就緒支援臺積電下一代的5納米制程技術。
博通Engineering for the ASIC Products Division副總裁GregDix表示,很高興能夠與臺積電合作共同精進CoWoS平臺,解決許多在7nm及更先進制程上的設計挑戰。
作者:流云
本站內容除特別聲明的原創文章之外,轉載內容只為傳遞更多信息,并不代表本網站贊同其觀點。轉載的所有的文章、圖片、音/視頻文件等資料的版權歸版權所有權人所有。本站采用的非本站原創文章及圖片等內容無法一一聯系確認版權者。如涉及作品內容、版權和其它問題,請及時通過電子郵件或電話通知我們,以便迅速采取適當措施,避免給雙方造成不必要的經濟損失。聯系電話:010-82306118;郵箱:aet@chinaaet.com。

